Mikroskopia sił atomowych

- Wizualizacja powierzchni Mikroskopia sił atomowych (AFM)
Mikroskopia sił atomowych
Mikroskopia sił atomowych (AFM) lub mikroskopia ze skanującą sondą (SPM) jest wysokorozdzielczą metodą obrazowania i pomiaru struktur powierzchni, umożliwiającą odwzorowanie płaszczyzny w trzech wymiarach, a także pozwalającą na mapowanie szeregu właściwości z bardzo wysoką rozdzielczością w płaszczyźnie oraz zdolnością do pomiaru stopni atomowych w osi Z. Poprzez implementację różnego rodzaju trybów pracy jak i typów sond pomiarowych, mikroskopia sił atomowych umożliwia mapowanie właściwości mechanicznych, elektrycznych, magnetycznych, a nawet przewodnictwa cieplnego. Metoda ta znajduje szerokie zastosowanie w obrazowaniu powierzchni próbek zarówno przewodzących elektrycznie, jak i nieprzewodzących. Ponadto, istnieje możliwość obrazowania próbek w różnych środowiskach pracy w tym: w powietrzu, w próżni, w cieczy (np. w roztworze elektrochemicznym) lub w atmosferze gazowej.
Odwzorowanie struktury powierzchni jak i jej własności odbywa się za pomocą mikrosondy pomiarowej, wykonanej najczęściej z krzemu luz azotku krzemu, oddziałującej z powierzchnią w próbki za pomocą niewielkiego ostrza o średnicy od 1 do kilku lub kilkudziesięciu nanometrów (10-9m).
Tryb True Non-ContactTM jest unikalną techniką pomiarową, która przy niezależnym układzie skanowania osi Z, pozwala na znaczne zmniejszenie poziomu interakcji ostrza skanującego z powierzchnią, przez co zmniejsza się zużycie ostrza, a tym samym utrzymuje się rozdzielczość obrazowania powierzchni na najwyższym poziomie przez długi okres czasu.
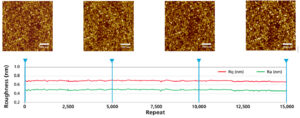
Rys. 2 Topografia powierzchni krzemu polerowanego zeskanowanego 15000 razy (3 dni), w trybie true non-contact, z szybkością skanowania 10Hz przy użyciu jednej sondy. Analiza chropowatości powierzchni wykazała zmiany wartości na poziomie <2%.
Tryb PinPointTM - umożlwiający wysokorozdzielcze obrazowania właściwości mechanicznych takich jak: moduł sprężystości, deformacja, siły adhezji, energia adhezji, rozproszenia, oraz sztywności. Ponadto to tryb ten może zostać rozszerzony o następujące techniki umożliwiające pomiar właściwości elektrycznych bądź di-elektrycznych, takich jak: przewodnictwo, rezystancja rozproszona czy właściwości piezoelektryczne:
- PinPoint Conductive AFM (C-AFM)
- PinPoint Piezoeletric Force Microscopy (PFM)
- PinPoint Spreading Resistance Microscopy (SSRM)

Rys. 3 Struktura powierzchni (z lewej), mapa sił adhezji (po środku), mapa modułu sprężystości
Scanning Ion Capacitance Microscpy (SICM) – mikroskopia z użyciem szklanej nano-pipety wypełnionej elektrolitem, umożliwiającej obrazowanie delikatnych struktur w roztworze elektrolitycznym.

Rys. 3 Porównanie topografii komórek uzyskanych metodą SICM (z lewej) z obrazem uzyskanym przy użyciu skaningowego mikroskopu elektronowego.

Rys. 4 Nanopipeta wykorzystywana przy pomiarach SICM.
Oprogramowanie SmartScan oraz XEI
Oprogramowanie SmartScan dostępne we wszystkich mikroskopach Park Systems, pozwala na szybką i łatwa i kontrolę procesu obrazowania. Już za pomocą trzech kliknięć można uzyskać wysokiej jakość skany, nie posiadając przy tym bogatego doświadczenia w pracy z mikroskopem.

Modele mikroskopów:
W naszej ofercie znajdują się modele mikroskopów sił atomowych firmy Park Systems mające zastosowanie w nauce oraz przemyśle. Są to modele dedykowane zarówno do małych próbek, takie jak: NX7, NX10, NX12, FX40 jak i modele mikroskopów przeznaczone do obrazowania podłoży krzemowych o średnicy 150mm, 200mm a nawet 300mm: NX20 lite, NX20, NX20 300mm.
Oprócz tego, jesteśmy w stanie Państwu zaoferować mikroskop sił atomowych zintegrowany ze spektrometrem IR (Park NX-IR), a także moduł mikroskopu sił atomowych opracowanych przez firmę Nenovision przeznaczony do integracji ze skaningowym mikroskopem elektronowym.

Mikroskop FX40
Najnowszy, zautomatyzowany mikroskop sił atomowych firmy Park Systems, oferujący innowacyjne rozwiązania, umożliwiające jeszcze łatwiejszą, szybszą i bardziej produktywną pracę przy obrazowaniu próbek. Zastosowane rozwiązania upraszczają proces obrazowania próbki do zaledwie kilku kroków.
W przypadku FX40 procesy związane z przygotowaniem mikroskopu do pracy, takie jak:
- montaż sondy;
- ustawienia wiązki lasera na sondzie;
- ustawienia wiązki lasera na fotodiodzie;
odbywają się automatycznie nie wymagają manualnej ingerencji ze strony użytkownika.
Operator musi jedynie wybrać miejsce na próbce i rozpocząć obrazowanie.
Mikroskop FX40 oferuje ponadto:
- tryb True Non-Contact dla lepszej precyzji obrazowania i mniejszego zużycia sond AFM;
- niezależne układy skanująca w osiach XY oraz Z, zapewniające sprawniejszą pracę pętli sprzężenia zwrotnego oraz odwzorowanie struktur powierzchni bez zniekształceń związanych z pracą układu skanującego;
- układ wbudowanych sensorów pozwalających na analizę otoczenia poprzez pomiar, m.in.: drgań, temperaturę lub wilgotność w celu oceny jakości warunków obrazowania;
- możliwość obrazowania próbek 20mm x 20mm (wysokość próbki do 20mm);
- mocowanie do 4 próbek za pomocą uchwytu magnetycznego lub za pomocą stolika Snap-In;
- zakres skanowania: 100um x 100um x 15um (XYZ);
Zastosowania:
- obrazowanie topografii: True Non-ContactTM; tryb kontaktowy AFM; tryb Tapping.
- właścwiości nano-mechaniczne: PinPointTM, Force Modulation Microscopy (FMM), Nanoindentacja, Nanoliotografia (w tym nanolitografia z wysokim napięciem), Nanoindentacja, Nanomanipulacja, LFM, Spektroskopia sił, obrazowanie Force Volume;
- właściwości elektryczne: Conductive AFM (C-AFM), spektroskopia I/V, sonda Kelvina, sonda Kelvina z użyciem wysokich napięć, mikroskopia pojemnościowa, mikroskopia SSRM, mapowanie foto-eletkryczne, EFM;
- właściwości di-elektryczne: mikroskopia oddziaływań piezoelektrycznych (w tym PFM z użyciem wysokich napięć), spektroskopia oddziaływań piezoelektrycznych;
- pozostałe: mikroskopia przewodnictwa cieplnego;
- dostępne akcesoria: stoliki temperaturowe, uniwersalna celka cieczowa, otwarta celka cieczowa dla systemu FX40, celka elektrochemiczna dla systemu FX40, obrazowanie płynną sondą, generator pola magnetycznego w zakresie od -300 gauss do 300 gauss.

Mikroskop NX7
Mikroskop sił atomowych o uniwersalnym zastosowaniu i bardzo dobrych parametrach, umożliwiający pracę w wielu technikach pomiarowych, zarówno tych podstawowych jak i zaawansowanych, a jednocześnie przystępny cenowo dzięki czemu jest bardzo dobrym rozwiązaniem dla laboratoriów i jednostek badawczych, posiadających ograniczony budżet.
- niezależne skanery Closed-Loop w osiach XY oraz Z – dostępne zakresy skanowania:
XY: 50um x 50um (opcjonalnie 10um x 10um lub 100um x 100um)
Z: 15um (opcjonalnie 30um).
- bogaty wybór dostępnych trybów pracy;
- prosta i intuicyjna obsługa;
- tryb True Non-Contact;
- możliwość obrazowania właściwości mechanicznych i elektrycznych w technice PinPoint
- zalecany rozmiar próbek: 50mm x 50mm w płaszczyźnie; wysokość do 20mm;
- przesuw próbki w płaszczyźnie: 13mm x 13mm - manualnie;
- zmotoryzowany ruch głowicy w osi Z w zakresie 26 mm;
Zastosowania:
- topografia: tryb kontaktowy AFM, tryb TappingMode AFM, tryb True Non-ContactTM;
- właściości elektryczne / magnetyczne: C-AFM; PinPoint C-AFM; spektroskopia IV; pomiar właściwości foto-elektrycznych; mikroskopia tunelowa STM; pomiar rezystancji SSRM; tryb pojemnościowy SCM; obrazowanie właściwości di-elektrycznych (EFM, KPFM), obrazowanie właściwości magnetycznych (MFM) z możliwością stosowania zmiennego pola magnetycznego;
- właściwości nanmechaniczne: spektroskopia F-D; PinPointTM; mikroskopia FMM; mikroskopia sił tarcia (LFM); Nanoindentacja; Nanolitografia; Nanomanipulacja.

Mikroskop NX10
Wysokiej klasy, uniwersalny mikroskop sił atomowych o wszechstronnych zastosowaniach oferujący pełnię możliwości badawczych.
- układ niezależnych skanerów osi X i Y, który umożliwia idealnie liniowy i ortogonalny przesuw próbki pod sondą oraz eliminujący geometryczne zniekształcenia obrazowania;
- zakres obrazowania w osiach XY: 50um x 50um (opcjonalnie: 10um x 10um; 100um x 100um);
- zakres pomiaru w osi Z: 15um (opcjonalnie 30um);
- dokładny pomiar topografii przy użyciu niskoszumowego detektora położenia oraz szybkiego serwo-mechanizmu w osi Z;
- tryb True Non-ContactTM, umożliwiający utrzymanie najwyższej możliwej rozdzielczości podczas skanowania i niskie zużycie sond pomiarowych w dłuższym czasie;
- dostępne zaawansowane techniki pomiarowe w tym obrazowanie właściwości mechanicznych lub elektrycznych za pomocą trybu PinPointTM;
- możliwość pracy z użyciem nanopipety kapilarnej SICM;
- możliwość obrazowania próbek o powierzchni 100mm x 100mm i wysokości do 20mm;
- Zastosowania:
- topografia: tryb kontaktowy AFM, tryb Tapping AFM, tryb True Non-Contact;
- właściości elektryczne / magnetyczne: C-AFM; PinPoint C-AFM; spektroskopia IV; pomiar właściwości foto-elektrycznych; mikroskopia tunelowa STM; pomiar rezystancji SSRM; tryb pojemnościowy SCM; obrazowanie właściwości di-elektrycznych (EFM, KPFM), obrazowanie właściwości magnetycznych (MFM) z możliwością stosowania zmiennego pola magnetycznego;
- właściwości nanmechaniczne: spektroskopia F-D; PinPointTM; mikroskopia FMM; mikro0skopia sił tarcia (LFM); Nanoindentacja; Nanolitografia; Nanomanipulacja;
- pozostałe: mikroskopia z użyciem nanopipety kapilarnej SICM, mikroskopia przewodnictwa termicznego STHM;

Mikroskop NX12
Uniwersalny mikroskop sił atomowych przeznaczony do obrazowania topografii jak i właściwości mechanicznych, magnetycznych oraz termicznych. Unikalną cechą mikroskopu jest dodatkowe oprzyrządowanie umożliwiające prowadzenie eksperymentów elektrochemicznych, takich jak:
- skaningowa mikroskopia elektrochemiczna (SECM),
- skaningowa mikroskopia elektrochemiczna z użyciem celki elektrochemicznej (SECCM),
- elektrochemiczna mikroskopia sił atomowych (EC-AFM).
Konstrukcja mikroskopu zintegrowana z mikroskopem optycznym, dzięki czemu możliwe jest obrazowanie przezroczystych próbek biologicznych m.in. w szalce Petri’ego lub na szkiełku mikroskopowym.
- zakres skanowania w osi Z: 15um (opcjonalnie 30um);
- zakres skanowania w osiach XY: 100x100um;
- możliwość obrazowania próbek o powierzchni: 50mm x 50mm (do wysokości 20mm) – zalecane 40mm x 40mm.
Zastosowania:
- obrazowanie: True Non-ContactTM, TappingMode, tryb kontaktowy AFM;
- właściwości elektryczne: PinPointTM Conductive AFM, Conductive Probe AFM, spektroskopia prądowo – napięciowe, mikroskopia EFM, sonda Kelvina, Dynamic Contact EFM, Piezoresponse Force Microscopy, Piezoresponse Force Spectroscopy, QuickStep SCM, Scanning Capacitance Microscopy SCM, Scanning Spread Resistance Microscopy SSRM, Mikroskopia Tunelowa STM, mapowanie właściwości foto-elektrycznych;
- tryby nano-mechaniczne: PinPointTM Nanomechanical Mode, spektroskopia F-D, obrazowanie Force Volume, mikroskopia FMM, LFM, Naonlitografia, Nanoindentacja, kalibracja stałej k.
- tryby specjalne: obrazowanie przewodnictwa termicznego, MFM, MFM z przestrajalnym polem magnetycznym,
- właściwości chemiczne: SECCM, SECM, EC-AFM, pomiary siłowe z użyciem sfunkcjonalizowanej sondy.
Na wyposażeniu mikroskopu dostępne są akcesoria umożliwiające prowadzenie badań przeżyciowych z wymianą buforu lub gazów, w kontrolowanej temperaturze.

Mikroskopy NX20
NX20 to seria mikroskopów sił atomowych z dużym stolikiem, pozwalająca na obrazowanie m.in. podłoży krzemowych 150 – 300mm. W skład serii NX20 wchodzą:
- NX20
- NX20 Lite
- NX20 300mm
Oprócz inspekcji podłoży krzemowych o średnicy do 300mm (NX20 300mm), mikroskopy sił atomowych serii NX20 oferują pełnię możliwości pomiarowych oraz wydajność pracy znaną ze wszystkich mikroskopów serii NX. Dodatkowo w mikroskopie NX20 300mm dostępne jest oprogramowanie SmartScan z automatycznym tworzeniem receptur, pozwalających na wykonywanie serii pomiarów przy minimalnym udziale operatora.
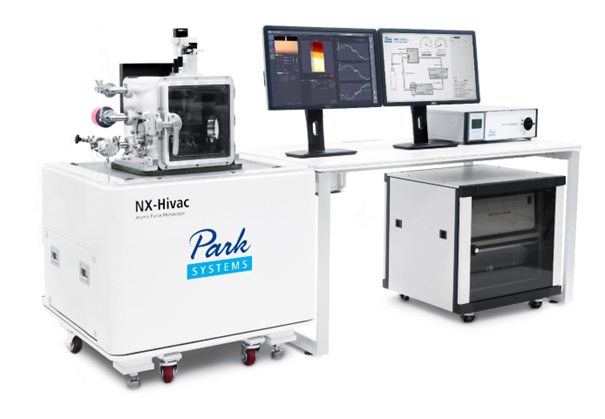
NX-Hivac
NX-Hivac to w pełni funkcjonalny mikroskop sił atomowych umożliwiający obrazowanie próbek w środowisku próżniowym. Stanowi on idealne rozwiązanie przy badaniach właściwości elektrycznych materiałów , w szczególności wrażliwych na kontakt z powietrzem, takich jak podatne na utlenianie półprzewodniki lub półprzewodniki organiczne. Zastosowany układ pomp (w tym pompy turbomolekularnej) oraz komory próżniowej pozwala na uzyskanie próżni rzędu 10-5 torra w czasie ok. 5 min. Oprogramowanie Hivac Manager pozwala na monitorowanie próżni w komorze oraz wentylowanie komory w łatwy i czytelny sposób. Mikroskop został wyposażony w stolik magnetyczny pozwalający na umocowanie jednocześnie 5 próbek o średnicy 10mm lub jednej próbki o średnicy 50mm.

Mikroskop sił atomowych NX-Hivac wyposażony został we wszystkie rozwiązania znane z pozostałych modeli serii NX takie jak:
- układ niezależnych skanerów osi X i Y, który umożliwia idealnie liniowy i ortogonalny przesuw próbki pod sondą oraz eliminujący geometryczne zniekształcenia obrazowania;
- zakres obrazowania w osiach XY: 50um x 50um (opcjonalnie: 10um x 10um; 100um x 100um);
- zakres pomiaru w osi Z: 15um (opcjonalnie 30um);
- dokładny pomiar topografii przy użyciu niskoszumowego detektora położenia oraz szybkiego serwomechanizmu w osi Z;
- tryb True Non-ContactTM, umożliwiający utrzymanie najwyższej możliwej rozdzielczości podczas skanowania i niskie zużycie sond pomiarowych w dłuższym czasie.
Oprócz tego głowica mikroskopu posiada zmotoryzowaną regulację układu fotodetektora w osi Z dzięki czemu istnieje możliwość regulacji ustawień bez konieczności każdorazowego wentylowania komory próżniowej.
Mikroskopy NX-IR
Seria Park NX-IR łączy w sobie możliwości obrazowania próbek za pomocą mikroskopu sił atomowych przy jednoczesnym charakteryzowaniu właściwości chemicznych za pomocą spektroskopii IR. Zasada działania mikroskopu oparta jest na opracowanej przez firmę Molecular Vista metodzie PiFM (Photo-Inducted Force Microscopy), wykorzystującej pomiar interakcji mechanicznych wynikających zarówno z oddziaływań krótko-zasięgowych umożliwiających obrazowanie topografii powierzchni jak i oddziaływań mechanicznych powstających poprzez foto-indukcję bliskiego pola. Mikroskop Park NX-IR pozwala zarówno na obrazowanie topografii jak i obrazowanie widm IR w wysokiej rozdzielczości, co umożliwia jeszcze dokładniejszą analizę chemiczną próbki. Widma IR uzyskane za pomocą mikroskopu Park NX-IR zachowują tym samym, ścisłą korelację z widmami uzyskanymi za pomocą konwencjonalnej spektroskopii FTIR. Metoda umożliwia detekcję materiałów na określonych głębokościach poprzez analizę pasm bocznych widma oscylacji.
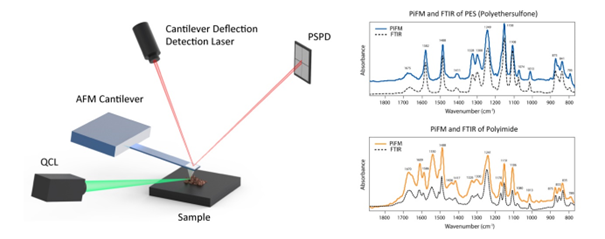
Mikroskop Park NX-IR R300 stanowi zintegrowane rozwiązanie dedykowane dla podłoży krzemowych do 300mm. Łączy on w sobie mikroskop sił atomowych NX20 300mm wraz ze spektrometrem IR firmy Molecular Vista. Dzięki takiemu połączeniu istnieje możliwość charakteryzacji chemicznej, mechanicznej oraz topografii podłoży półprzewodnikowej z rozdzielczością lateralną <10 nm, dzięki użyciu bezkontaktowego trybu pracy.

Mikroskop Park NX-IR R300

Nenovision LiteScope AFM-in-SEM
Moduł mikroskopu sił atomowych instalowany wewnątrz komory skaningowego mikroskopu elektronowego, pozwalający na jednoczesne obrazowanie przy użyciu mikroskopu sił atomowych jak i mikroskopii SEM.
- wymiary modułu pomiarowego: 118 mm x 84 mm x 35.7 mm – 48.4 mm;
- możliwość pracy w próżni o zakresach (105 do 10-5 Pa);
- zakres skanowania XYZ: 100 um x 100 um x 20 um;
- zakres skanowania XYZ Closed Loop: 80 um x 80um x 16 um;
Kompatybilność z mikroskopami SEM, m.in.: Thermo Fischer Scientific, TESCAN, ZEISS, Hitachi, JEOL.
Techniki pomiarowe:
- Mechaniczne: Topografia AFM, Rozpraszanie energii, Kontrast fazowy, Nanoindentacja;
- Elektryczne: C-AFM, KPFM, EFM, STM;
- Magnetyczne: MFM (mikroskopia sił magnetycznych);
- Electro-mechaniczne: PFM
- Spektroskopia: F-Z, spektroskopia I-V
- Korelacyjne: CPEM

Technika CPEM
Typowa konfiguracja mikroskopu NenoVision LiteScope AFM-in-SEM:





