Grubość cienkich warstw jest krytycznym parametrem w procesie produkcji. Popyt na precyzyjne, a zarazem szybkie pomiary dla ultracienkich warstw ciągle wzrasta. Dodatkowo, nowe technologie, takie jak urządzenia oparte materiałach 2D zwiększają tę potrzebę. Stan wiedzy w dziedzinie kontroli grubości warstwy obejmuje czujniki oparte na interferometrii i reflektometrii lub czujniki konfokalne, a także klasyczną elipsometrię. W większości przypadków te techniki nie są w stanie precyzyjnie zmierzyć grubość ultracienkich warstw, albo nie są w stanie zmierzyć grubość z „jednego strzału” (ang. single shot).
Nowym podejściem, opracowanym przez Accurion jest spektralna elipsometria odniesienia (rse), w której próbka jest porównywana ze szczegółowo wybranym odniesieniem.

Nanofilm_RSE to specjalny rodzaj elipsometru, w którym próbka jest porównywana z odniesieniem. Dzięki temu różnica elipsometryczna między próbką i odniesieniem może zostać zmierzona. Ze względu na układ odniesienia, żaden z elementów optycznych nie musi być przemieszczany lub modulowany w czasie pomiaru, a wysokiej rozdzielczości widma mogą być uzyskane w pomiarze typu single-shot. W ten sposób zbierane jest 100 pomiarów spektralnych na sekundę. W połączeniu ze zsynchronizowanymi stolikami w osi X oraz Y duża mapa grubości warstwy na podłożu może zostać otrzymana w zaledwie kilka minut.
Główne cechy urządzenia
| zakres spektralny | 450-900nm |
| prędkość zbierania danych | 100 pełnych widm na sekundę |
| rozmiar plamki | ~100μm |
| stoliki | automatyczne stoliki w osi X oraz Y |
| zakres stolików | 200mm |
| rozdzielczość grubości warstw | 0,1nm |
| powtarzalność pomiarów grubości | ±0,5% |
Pozostałości z fizycznej absorpcji na folii plastikowej


Kawałek folii z tworzywa sztucznego, usunięty z próbki powinien nie posiadać żadnych pozostałości. Pomiar elipsometrem wyraźnie pokazuje kształt usuniętej folii ─ oczywiście pewne resztki pozostały niewidoczne. Problemy w procesach osadzania może występować z powodu takich właśnie skażeń.
Polistyren na krzemie naniesiony metodą spin-coating

Podłoże krzemowe powleka się polistyrenu w procesie wirowania. Mapy grubości warstwy zostały uzyskane w czasie niecałych 2 minut stosując nanofilm_RSE.

Wykres pokazuje wahania widmowe spowodowane wzrostem grubości warstwy (grubości od niebieskiego do czerwonego).
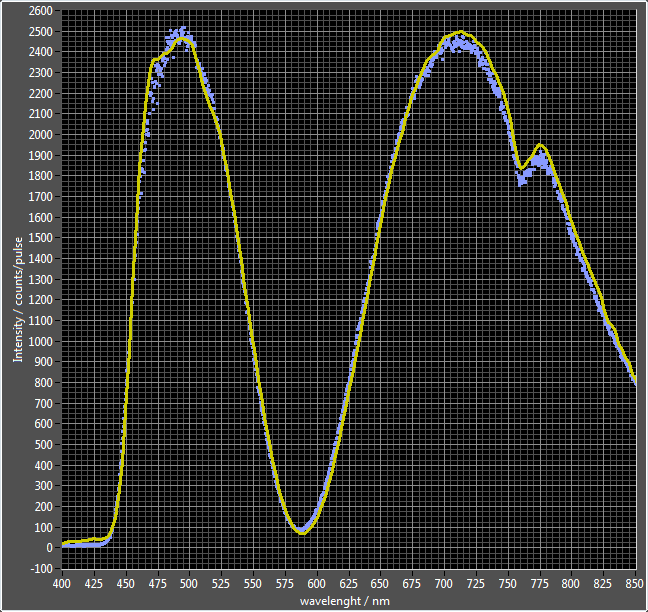
Na powyższym wykresie pokazano dopasowanie widma optycznego. Niebieskie punkty pokazują dane widmowe, a zielona krzywa to dopasowanie.
Mapa grubości tlenku krzemu na 4” płytkach

Warstwy o różnych grubościach tlenku krzemu na 4” płytkach. Średnia grubość wynosi od 400nm do 500nm. Mapa zebrana została w ciągu 5min 40s.

Zmienność spektralna grubości warstwy od niskiej (niebieski) do dużych wartości (czerwony).