Badanie grafenu techniką elipsometrii obrazującej

- aplikacje Badanie grafenu techniką elipsometrii obrazującej
Porównanie metod badania grafenu oraz tlenku grafenu
Grafen oraz tlenkowe warstwy grafenowe są zlokalizowane i charakteryzowane różnych podłożach, za pomocą spektroskopowej elipsometrii obrazującej nanofilm_ep4se. Grubość i funkcje dyspersji współczynnika załamania n oraz ekstynkcji k uzyskiwane są dla kilku μm szerokich warstw. Wyniki obrazowania elipsometrycznego zgadzają się z wynikami uzyskanymi za pomocą kombinacji AFM oraz mikroskopii konfokalnej w obrębie błędów. W przeciwieństwie do tych ostatnich sposobów, czas pomiaru jest o wiele krótszy w przypadku elipsometrii obrazującej.
Grafen jest dwuwymiarową warstwą trójwymiarowego grafitu. Zainteresowanie grafenem jest spowodowane przez znakomite właściwości elektroniczne tego materiału i potencjalne zastosowania elektroniczne. Wykazuje on wysoką jakość kryształu, transport elektronów w skali submikronowej (nawet w warunkach standardowych otoczenia) i jego nośniki ładunku mogą dokładnie naśladować bezmasowe fermiony Diraca. Próbki grafenu obecnie stosowanego w doświadczeniach są zwykle wytwarzane przez mikromechaniczne rozszczepienie grafitu. Chociaż grafen jest prawdopodobnie produkowany za każdym razem gdy ktoś używa ołówka, to jest bardzo trudne znalezienie małych krystalitów grafenowych w “stogu siana” milionów grubszych płatków grafitu, które pojawiają się podczas rozszczepienia. W rzeczywistości, nowoczesne techniki wizualizacji (w tym mikroskopie sił atomowych, skaningowa tunelowa oraz elektronowa) mają trudności w znalezieniu grafenu ze względu na ich bardzo niską przepustowość w wymaganej rozdzielczości atomowej lub brak jasnego rozpoznawania pojedynczych warstw atomowych od grubszych
płatków. Nawet mikroskopia Ramana, która niedawno sprawdziła się jako potężne narzędzie dla odróżnienia pojedynczych warstw grafenowych, nie został jeszcze zautomatyzowana, aby umożliwić wyszukiwanie krystalitów grafenu. Co więcej, różnice pomiędzy dwoma warstwami i kilkoma warstwami arkuszy grafenu nie są widoczne w widmach Ramana.
Mimo to, pomiar mikroskopią sił atomowych (AFM) jest najbardziej bezpośrednim sposobem identyfikacji grubości grafenu, metoda ma powolną przepustowość i może również spowodować uszkodzenie sieci krystalicznej podczas pomiaru. Ponadto interpretacja otrzymanych wartości grubości jest trudna do interpretacji ze względu na adsorbencje w arkuszu w warunkach otoczenia.
Do tej pory, jedynym sposobem, aby wyizolować grafen jest rozszczepianie grafitu w górnej części utlenionego wafla krzemowego, a następnie ostrożne skanowanie jej powierzchni, przy użyciu mikroskopu optycznego. Cienkie płatki są wystarczająco przejrzyste, aby dodać je do ścieżki optycznej, która zmienia swój kolor w odniesieniu do pustej płytki. Kontrast widma i kontrastowe obrazy na SiO2 lub folii PMMA lub Si3N4 mogą być wykorzystywane do określenia ilości i właściwości optycznych warstwy grafenu. To samo dotyczy sposobu kontroli warstw tlenku grafenu, który
jest materiałem, który może być eksfoliowany z wytworzeniem trwałych zawiesin koloidalnych w wodzie.
W odpowiednim stężeniu, odparowywanie kropelek tej zawiesiny koloidalnej tworzy na powierzchni warstwy tlenku grafenu. Materiał ten zwraca szczególną uwagę jako wypełniacz anokompozytów, jak również jako materiał papiero podobny. Jako alternatywę dla grafenu kilka warstw lub nawet jedną warstwa tlenku grafenu jest obiecująca.
W tym zastosowaniu zarówno grubość jak i współczynnik załamania i ekstynkcji tlenku grafenu są mierzone metodą spektroskopowej elipsometrii obrazującej na pojedynczej warstwie tlenku grafenu na Si3N4/SiO2/Si-podłoże. Po tym możemy zastosować tę technikę do badania kilku warstw grafenu na podłożu GaAs.
Przykładowe pomiary:

Kravets et al. (2010) Phys. Rev. B 81

Wurstbauer et al. (2010) Appl. Phys. Lett. 97

Obrazowanie i mapowanie elipsometryczne- przykład mapy Psi
Pomiary tlenku grafenu
Arkusze grafenu i tlenku grafenu są łatwe do znalezienia na kontrastowym obrazie w czasie rzeczywistym z nanofilm_ep4. Widmo psi tlenku grafenu zostało zapisane jako wartość średnia z czterech stref elipsometrycznych, w celu zapewnienia jak najlepszej dokładności. Widmo jest dopasowane w oparciu o prosty model optyczny, który zawiera co najmniej jedną warstwę optycznie izotropową tlenku grafenu na podłożu. Podłoże pod tlenkiem grafenu ma warstwę Si3N4 i naturalnego SiO2 na płytce krzemowej. Jeden widmo zostało zarejestrowane na podłożu obok arkusza tlenku grafenu. Z dopasowania częstotliwości uzyskuje się grubość obu warstw z Si3N4 SiO2. Parametry te są utrzymywane na stałym poziomie w modelu, gdy widmo ROI 0 na pojedynczej warstwie tlenku grafenu jest dopasowane dla grubości, współczynnika załamania światła i ekstynkcji tlenku grafenu. Otrzymane wyniki porównano z pomiarami według mikroskopii sił atomowych (AFM) i konfokalnej mikroskopii (tabela poniżej).
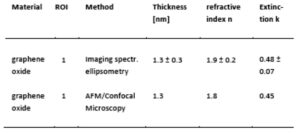
Wyniki, podobny margines błędu dla grubości, współczynnika załamania i ekstynkcji dla grafenu (poprzednia generacja obecnego elipsometru obrazującego Accurion).
Pomiary grafenu
Widma Delta i Psi zarejstrowano w ROI z n arkuszy grafenu na podłożu GaAs. Widma ROI 0 i 2 znajduja się na czystym GaAs, zostały one dopasowane dla funkcji dyspersyjnych współczynnika załamania n (λ) i ekstynkcji k (λ).
Funkcje te zostały następnie wykorzystane do dopasowania widma ROI 1 i 3 grafenu do grubości, współczynnika załamania światła i ekstynkcji. W celu uzyskania profilu grubości poprzecznej o wysokiej rozdzielczości, jedna mapa mikroskopowa Delta została zebrana i przekształcona w mapę grubości warstwy grafenu.
Szczegóły mapy Delta otrzymane przy długości fali 502 nm oraz kącie 50° dla pola widzenia 22 μm x 29 μm warstwy grafenu na podłożu GaAs, zarejstrowanej w ciągu 1 minuty.
Uzyskane współczynnik załamania i ekstynkcji były utrzymywane na stałym poziomie do konwersji z Delta do grubości. Jeśli parametry optyczne powinny zmieniać się w arkuszu grafenu, byłoby to opcją nanofilm_ep4, aby zbierać i dopasowywać spektrum map Delta i Psi. Widmo mapy powinno być dopasowane tym samym modelem optycznym, który został użyty w celu dopasowania do widm ROI. W ten sposób, można otrzymać mapy ekstynkcji, współczynnika refrakcji i grubość.
Podsumowanie
Porównując elipsometrię obrazującą z AFM i mikroskopię konfokalną (CM): AFM musi mierzyć grubość, aby umożliwić uzyskanie współczynnika załamania i ekstynkcji z mikroskopii konfokalnej, ponieważ CM sama w sobie nie ma wystarczającej dokładności pomiaru wszystkie trzy parametry: grubość, współczynnik załamania światła i ekstynkcji są niezależnie od siebie. Połączenie AFM CM do badania arkusza tlenku grafenu wymaga mechanizmu umiejscowienia próbki w taki sposób, że możliwy jest pomiar wybranych punktów przez oba urządzenia. Taki mechanizm nie jest wymagany w przypadku elipsometru obrazującego. Nanofilm_ep4 mierzy właściwości optyczne, profile grubości oraz mapy w ciągu minut. W przeciwieństwie do AFM, obrazująca elipsometria jest techniką szybką i nieniszczącą.
Wyniki obu metod na tlenku grafenu mieściły się w marginesie błędu (wyniki są zawarte w tabeli powyżej). Elipsometria obrazująca została zastosowana również do kilku arkuszy grafenu na różnych podłożach. Należy zbadać, jak uniwersalna jest ektynkcja i współczynnik załamania dla grafenu.
Z obrazującym elipsometrem nanofilm_ep4se można mieżyć funkcję rozproszenia współczynnika załamania i ekstynkcji, oraz grubość powłoki grafenu i tlenku grafenu. Pomiar z nanofilm_ep4 jest szybszy niż w przypadku metod alternatywnych, to znaczy połączenie AFM z CM lub kombinacja mikroskopu optycznego z AFM/SNOM i spoektroskopią Ramana. Nanofilm_ep4 jest także tańszą techniką.
Przykładowe pomiary grafenu metodą elipsometrii obrazującej Accurion
1.Ulrich Wurstbauer, Christian Röling, Ursula Wurstbauer, Werner Wegscheider, Matthias Vaupel, Peter H. Thiesen, oraz Dieter Weiss, Applied Physics Letters 97, 231901 (2010)
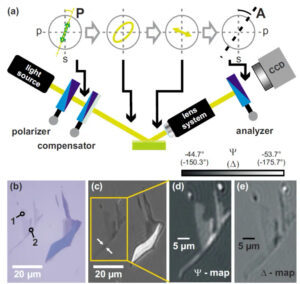
a) schemat elipsometru obrazującego: system obiektywów zamontowany pomiędzy próbką i analizatorem umożliwia obrazowanie z submikronową
rozdzielczością poprzeczną
b) oraz c) elipsometryczny obraz intensywności próbki na podłożu SiO2/Si pokazujący regiony z monowarstwą grafenu do grubości cienkiego grafitu
d) oraz e) elipsometryczne mapy odpowiednio Ψ i Δ wcześniejszych obszarów warstw grafenu z większą rozdzielczością

a) obraz SEM kilku warstw grafenu na podłożu GaAs, płatek jest w środku zaznaczonego obszaru
b) oraz c) działki IEI tego samego obszaru. Na obrazie b kontrast zoptymalizowany jest tak, że pozostałości taśmy znikają, natomiast w c kontrast w bezpośrednim sąsiedztwie jest zwiększony.
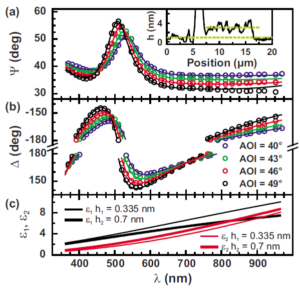
a) Długość fali zależna od kąta Ψ monowarstwy grafenu dla różnych AOI. Profil wysokości płatków na GaAs pokazany jest na poprzednim obrazie.
b) Zależność długości fali od kąta Ψ tego samego AOI, tak samo jak współczynniki dielektyczne (c) ∈1 i ∈2 grafenu dla teoretycznych wysokości warstw h1=0,0335nm (cienkie linie) oraz wysokość mierzona AFM h2=0,7 nm (grube linie)
2. Matković A., Beltaos A., Milićević M., Ralević U., Vasić B., Jovanović D. Gajić R. (2012) J. Appl. Phys. 112

Mikroskopowe obrazy optyczny (po lewo) oraz kontrastowy elipsometryczny (po prawo) mierzonych próbek grafenu przy 90 nm warstwie SiO2 (a) oraz 300 nm warstwie (b)
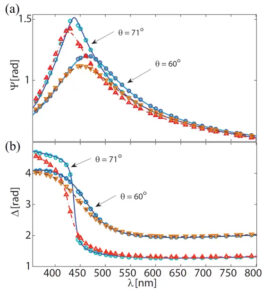
Pomiarów dokonywano przy dwóch kątach: 60° oraz 71°, z tym samym ROI.
3. Albrektsen O. et al. (2012) J. Appl. Phys. 111, 064305
W pracy tej zaprezentowano z powodzeniem sposób w jaki elipsometria obrazująca może być stosowana do otrzymywania map wysokiej rozdzielczości dla próbek kilku warstw grafenu, wyniki uzyskane były potwierdzone przy wykorzystaniu innych dostępnych technik.
Otrzymany obraz próbki FLG na SiO2/Si-podłoże, wraz z oznaczonymi ROI i widmami:
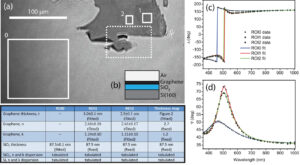
Otrzymana mapa grubości (a) z odpowiadającym widokiem 3D (b) badanej próbki, otrzymane zostały przez dopasowanie piksel po pikselu zmierzonej D-mapy, zarejstrowanej przy 658 nm.

Poniżej map znajdują się profile wysokości zebrane z obszarów oznaczonych na rys. a. Pierwszy profil odpowiada obszarowi oznaczonemu na rysunku niżej.